삼성전자는 16~19일(현지시간) 미국 새너제이에서 열리는 엔비디아 GTC에서 HBM4E 실물 칩과 코어 다이 웨이퍼를 최초로 공개했다고 17일 밝혔다.
|
삼성전자는 이번 전시에서 ‘HBM4 히어로 월(HBM4 Hero Wall)’을 통해 HBM4를 중심으로 메모리와 로직, 설계, 파운드리(반도체 위탁생산), 첨단 패키징을 아우르는 종합반도체기업(IDM)으로서 강점을 부각했다.
HBM은 D램을 수직으로 쌓아 올리는 칩으로, HBM4부터는 로직 다이(베이스 다이) 위에 D램을 적층하는 방식이 적용된다. 로직 다이는 중앙처리장치(CPU)와 같은 프로세서처럼 HBM을 제어하는 역할을 한다. 고객이 원하는 맞춤형 기능을 구현하는 공정을 거친다. 이에 따라 메모리 기술 경쟁력뿐 아니라 베이스 다이 설계 역량과 첨단 패키징 기술의 중요성이 더욱 커지고 있다.
|
또 삼성전자는 영상을 통해 차세대 패키징 기술인 하이브리드 본딩(HCB)을 공개한다. 패키징은 AI 반도체 성능을 좌우하는 핵심 요소로 주목받고 있다. 삼성전자가 선보인 HCB 기술은 기존 열압착본딩(TCB) 대비 열 저항을 20% 이상 개선했으며, 16단 이상의 고적층 구현을 지원한다.
|
삼성전자는 ‘베라 루빈’ 플랫폼을 구현하는 메모리 토털 솔루션을 공급할 수 있는 회사라는 점을 부각했다. 베라 루빈은 엔비디아의 차세대 AI 슈퍼칩으로, CPU ‘베라’와 그래픽처리장치(GPU) ‘루빈’을 결합해 AI 추론에서 비용과 전력 효율을 극대화한 플랫폼이다.
삼성전자는 메모리 공급사 가운데 유일하게 △HBM4 △소캠(SOCAMM)2 △서버용 SSD PM1763이 모두 탑재된 실물을 선보였다. 또 전시장 내에 ‘엔비디아 갤러리(NVIDIA Gallery)’를 별도 구성해 양사 간 긴밀한 협력을 강조했다.
|
송용호 삼성전자 AI센터장은 이날 엔비디아의 특별 초청을 받아 발표에 나선다. 송 센터장은 엔비디아 차세대 시스템이 AI 인프라 혁신에서 갖는 의미와 이를 지원하는 삼성전자의 메모리 토털 솔루션 비전을 소개할 예정이다. 양사의 협력은 단순한 기술 협력을 넘어 AI 인프라 전반으로 확대되고 있다는 평가다.
업계 한 관계자는 “AI 시대 경쟁의 핵심은 최고 사양의 단일 제품이 아니라 통합된 시스템 대응력으로 이동하고 있다”며 “시스템 수준에서 성능과 효율을 끌어올릴 수 있는 최적화된 인프라 구축이 핵심”이라고 말했다.


.png)
.png)




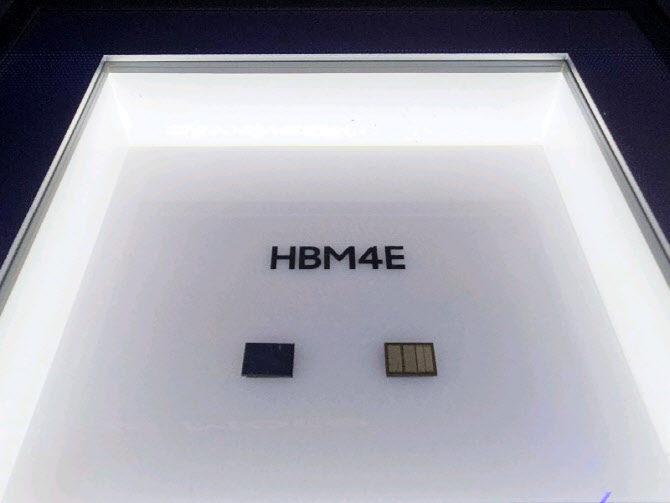
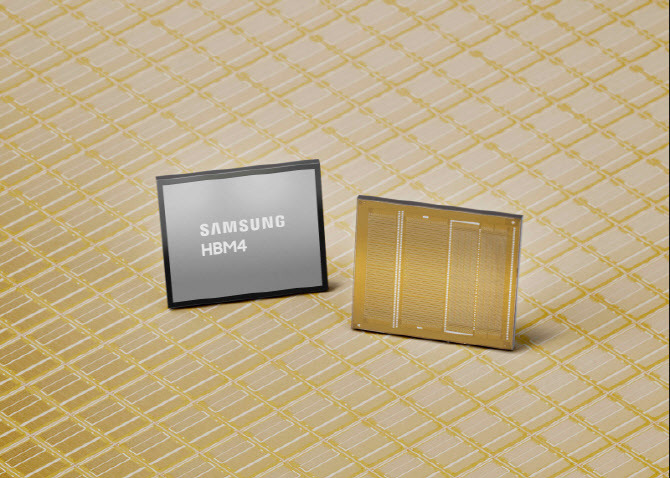



![尹이 밀어붙인 글로벌 R&D, 국내기관 보호장치도 부족했다[only 이데일리]](https://image.edaily.co.kr/images/vision/files/NP/S/2026/04/PS26042400610t.jpg)



